研究 (Research)
最終更新日:
SiCヒーターチップを用いたパワーモジュール熱評価と構造信頼性評価システムの開発 (Development of power module thermal evaluation and structural reliability evaluation system using SiC heater chip)
特任准教授(常勤) 陳 伝彤、特任教授 菅沼 克昭(産業科学研究所 フレキシブル3D実装協働研究所) CHEN Chuantong , SUGANUMA Katsuaki(SANKEN (The Institute of Scientific and Industrial Research))
研究の概要
次世代のパワー半導体を用いたパワエレ技術を駆使した電力変換器の高出力密度化、小型化と電力損失の低減の実現が期待されている。また、極限状態で動作するパワー半導体は、その熱特性の正しい評価が材料開発のみならず信頼性評価の観点からも特に重要である。その高い信頼性を実現するためには、発熱状態を理解した上で放熱構造などを適切に設けた温度制御が鍵となる。
本研究では、パワー半導体の動作による発熱を疑似的に発生させることで実装プロセス等の性能評価、信頼性評価を効率的に行う熱評価用疑似発熱チップ(Thermal-test Engineering Group, TEG)を設計・開発した。TEG チップを用いたパワーモジュールのパワーサイクル試験を模擬し、従来の鉛フリーはんだより Ag 焼結接合構造が高い信頼性を持つことが証明された。
研究の背景と結果
次世代のパワー半導体である SiC や GaN などワイドバンドギャップ(WBG)・パワー半導体を用いたパワーエレクトロニクス技術を駆使した電力変換器の高出力密度化、小型化と電力損失の低減の実現が期待されている。今後 WBG パワー半導体の市場拡大には、WBG パワーモジュールのさらなる小型化と大電力変換が必要となる。2030年には電力密度が現状の ~100W/cm2から300W/cm2に、また Si では到達できない300℃近い極限環境動作が望まれる。厳しい使用環境で WBG半導体パッケージ中の半導体/樹脂/金属/セラミックスなど異種材材料界面は、それぞれの物性の違いにより発生する厳しい劣化と損傷の蓄積に曝される。正しい熱特性の評価は、WBG 半導体デバイス材料開発と信頼性評価に必要不可欠である。
現在、WBG半導体デバイスパッケージ熱特性評価は過渡熱抵抗評価で行われるが、この評価が可能な装置は,メンター・グラフィックス社のT3Ster3しか存在しない。また、現状は各種デバイスごとに実際に実装して熱特性を評価しなければならず、パワーモジュールとしての実動作評価を行うためには、大電力を長時間投入し続ける必要がある。そのため、モジュールとしての熱マネージメントの設計によるコスト増加や開発スピードの遅延が生じ技術の進展の障害となっている。
また、過渡熱抵抗評価は半導体パワーデバイス動作を止めて、測定することになるため、連続的な動作環境で熱特性の評価が不可能であり、特に、単一のパワーデバイスチップにしか対応できない。
上記の課題を解決するため、本研究では、パワー半導体の動作による発熱を疑似的に発生させることで実装プロセス等の性能評価、信頼性評価を効率的に行う熱評価用疑似発熱チップ(Thermal-test Engineering Group, TEG)を設計・開発し、熱マネージメント評価方法を開発した。TEGチップへの電源On/offのコントロールでパワーサイクル試験を行い、従来の鉛フリーはんだより Ag 焼結接合構造が高い信頼性を持つことが証明された。
結果として、従来は実チップ、パワーサイクル試験機および T3Ster3からなる大掛かりな構成からのみ測定可能だったが、TEG チップを利用することにより、実装材料放熱特性の評価および全体的なモジュール構造の信頼性評価までをTEG チップの電源 On/off コントロールにより簡便な形で実現することができた。
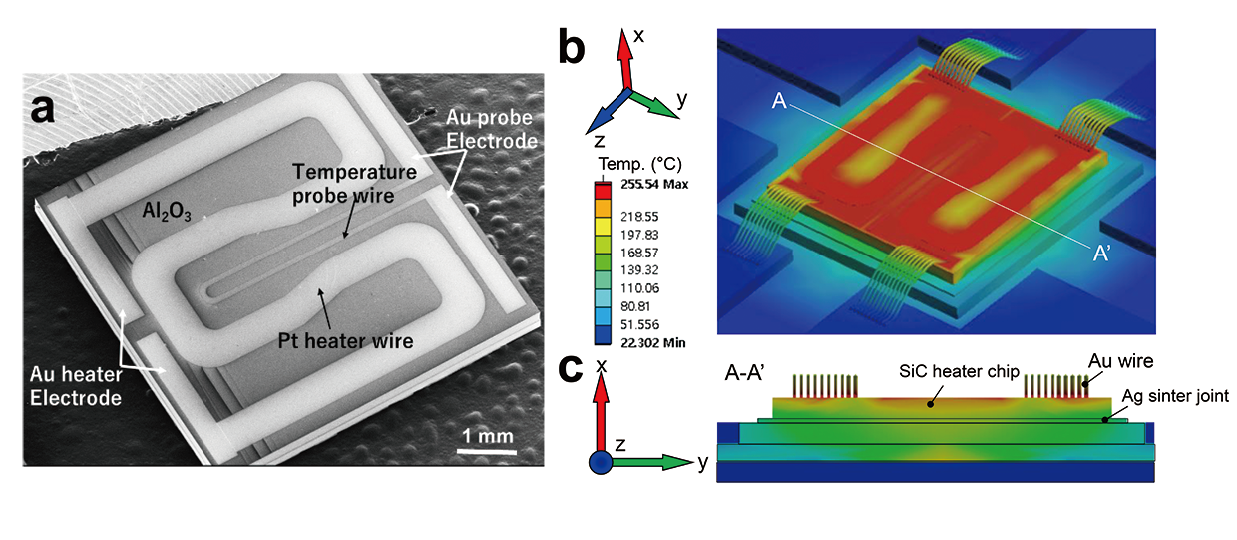
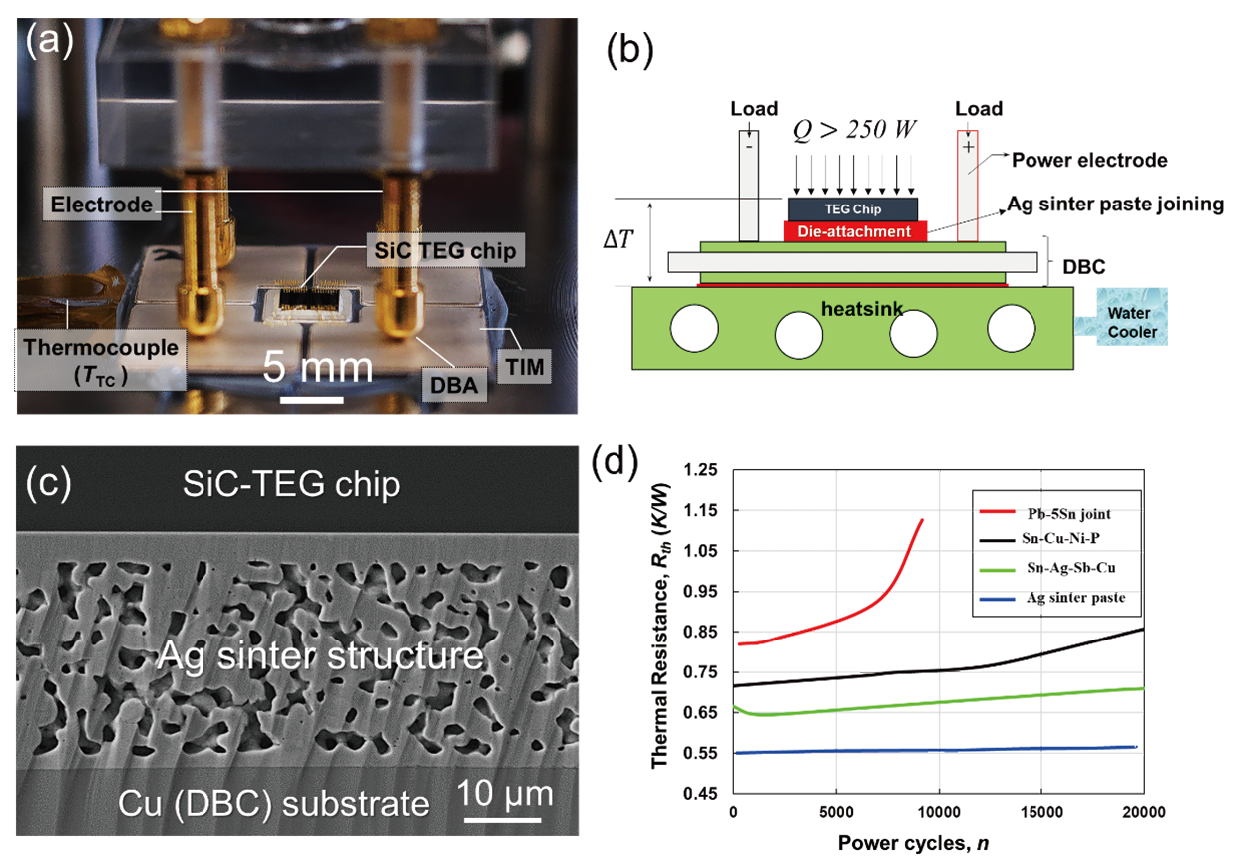
研究の意義と将来展望
従来は実チップ、パワーサイクル試験機および T3Ster3からなる大掛かりな構成からのみ測定可能だったが、TEG チップを利用することにより、実装材料放熱特性の評価および全体的なモジュール構造の信頼性評価までを TEG チップの電源 On/off コントロールにより簡便な形で実現することができた。この成果は、実装材料開発メーカー、基板メーカーおよび関連のパワーモジュール製造メーカーでは低コストかつ短周期で熱特性と信頼性評価を可能とするため、大きく注目された。
担当研究者
特任准教授(常勤) 陳 伝彤、特任教授 菅沼 克昭(産業科学研究所 フレキシブル3D実装協働研究所)
キーワード
パワーエレクトロニクス/SiC ヒーターチップ/熱抵抗測定/Ag 焼結接合
応用分野
パワーデバイス/EV/HEV/ドローン/宇宙航空/5G/6G通信
